刀痕,自动校准基准线位置,防止崩边过大及切片造成良率的损失。能进行测高并同步切割作业时对切割刀刃进行实时检测。清洗部位配备水汽二流体清洗装置,能对加工物进行清洗。半自动划片机LX3356机台可作业8时wafer,含自动光学补偿、聚焦及自特征点功能,配有高低倍两种镜头,可用于切割道宽度测量、基准线补偿调整等。可自动检测切割刀痕,自动校准基准线位置,防止崩边过大及切片造成良率的损失。能进行测高并同步切割作业时对切割刀刃进行实时检测。
顶面碎片,它发生晶圆的顶面,变成一个合格率问题,当切片接近芯片的有源区域时,主要依靠刀片磨砂粒度、冷却剂流量和进给速度。
背面碎片发生在晶圆的底面,当大的、不规则微小裂纹从切割的底面扩散开并汇合到一起的时候。当这些微小裂纹足够长而引起不可接受的大颗粒从切口除掉的时候,BSC变成一个合格率问题。如果背面碎片的尺寸在10um以下,忽略不计。另一方面,当尺寸大于25um时,可以看作是潜在的受损。可是,50um的平均大小可以接受,示晶圆的厚度而定。
切片工艺变得越来越且要求高。切割迹道变得越窄,可能充满测试用衰耗器(test pad),并且刀片可能需要切割由不同材料制成的各种涂敷层。在这些条件下达到大的切片工艺合格率和生产率要求认真的刀片选择和的工艺控制能力。
通常来说,对于小芯片减薄划片时使用UV膜,对于大芯片减薄划片时使用蓝膜,因为,UV膜的粘性可以使用紫外线的照射时间和强度来控制,防止芯片在抓取的过程中漏抓或者抓崩。若芯片在减薄划切实之后,直接上倒封装标签生产线,那么好使用UV膜,因为倒封装生产线的芯片一般比较小,而且设备的顶针在蓝膜底部将芯片顶起。如果使用较大粘性剥离度的蓝膜,可能使得顶针在顶起芯片的过程中将芯片顶碎。
硅圆片切割应用的目的是将产量和合格率大,同时资产拥有的成本小。可是,挑战是增加的产量经常减少合格率,反之亦然。晶圆基板进给到切割刀片的速度决定产出。随着进给速度增加,切割品质变得更加难以维持在可接受的工艺窗口内。进给速度也影响刀片寿命。在许多晶圆的切割期间经常遇到的较窄迹道(street)宽度,要求将每一次切割放在迹道中心几微米范围内的能力。这就要求使用具有高分度轴精度、高光学放大和对准运算的设备。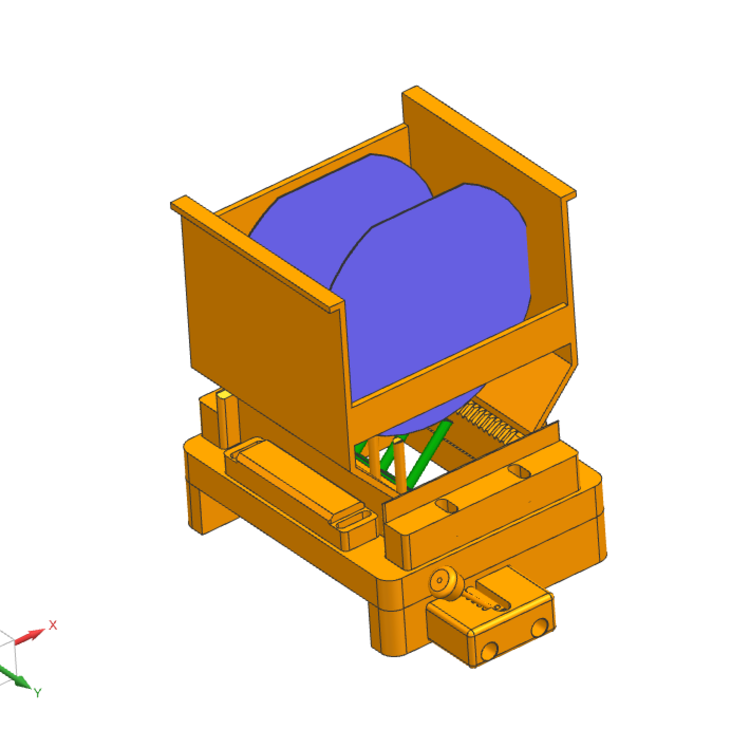
在芯片的分割期间,刀片碾碎基础材料(晶圆),同时去掉所产生的碎片。材料的去掉沿着晶方(dice)的有源区域之间的切割线(迹道)发生的。冷却剂(通常是去离子水)指到切割缝内,改善切割品质,和通过帮助去掉碎片而延长刀片寿命。每条迹道(street)的宽度(切口)与刀片的厚度成比例。