BGA芯片(Ball Grid Array)是一种集成电路封装技术,其引脚以球形焊点排列在芯片底部,通常用于高密度的集成电路封装。拆卸和加工BGA芯片需要谨慎和的操作,因为这些芯片对于错误的操作非常敏感,容易损坏。
要拆卸和加工BGA芯片,通常需要以下步骤:
1. 准备工作:确保工作环境清洁,使用防静电设备以防止静电损坏芯片。准备必要的工具,如热风枪、烙铁、焊锡等。
2. 加热芯片:使用热风枪加热BGA芯片,以软化焊料。温度和时间的控制非常关键,应根据具体芯片型号和封装材料选择适当的加热参数。
3. 移除芯片:一旦焊料软化,可以使用吸锡器或烙铁轻轻地将芯片从PCB上移除。务必小心,避免在移除过程中对芯片或PCB造成机械损伤。
4. 清洁PCB:在芯片移除后,使用酒精或其他清洁剂清洁PCB,以去除残留的焊料或污垢。
5. 重新安装:如果需要,可以将新的BGA芯片安装到PCB上。这个过程需要的焊接技巧和适当的设备,确保所有连接点都正确焊接。
深圳市卓汇芯科技有限公司
主营业务有:BGA植球, QFN除锡,QFP除锡 , IC研磨刻字、 IC激光烧面、 IC盖面刻字、 IC编带抽真空 、IC拆板翻新、 等。保护知识产权,防止技术泄密。可加工各种封装的IC:BGA/ OFN/ DIP/ DDR/ EMMC/ EMCP/ SSD/ SOP/ SSOP/ SOT/ TO/ PLCC系列以及各种不规则封装。
SMT贴片炉后BGA返修焊接
全程用料环保,防静电处理,客户信息高度保密。本公司以高素质的人才,多年的芯片加工经验及率、高精细的加工设备,竭诚为广大客户提供的服务!
公司经营宗旨:品质、客户至上!欢迎各位新老客户前来我司实地考察指导!
BGA芯片植球加工是一种电子元器件制造过程,其中BGA(Ball Grid Array)芯片的焊球被加工到电路板上。这个过程通常涉及将焊球粘附到BGA芯片的焊盘上,然后通过热处理使焊球与电路板焊接在一起。这种技术通常用于高密度集成电路的制造,因为BGA芯片可以提供更多的引脚密度和更好的电气性能。

恒温加热台加热平台加热返修平台高温加热台。
1元
产品名:返修台,加热台,恒温台,加热平台

SOP8SOP16TSOP芯片编带加工BGA除锡除氧化植球
1元
产品名:BGA编带,QFP编带,QFN编带,SOP编带
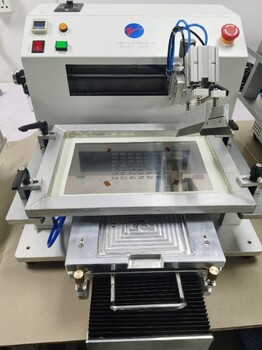
QFN清洗QFN编带包装QFN返修QFN焊接SMT贴片
1元
产品名:smt贴片,dip插件,qfn清洗,bga磨平

BGAQFNQFP废旧芯片翻新加工重新植球清洗包装
1元
产品名:smt贴片,dip插件,qfn清洗,bga磨平
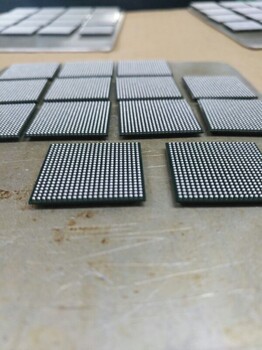
IC芯片翻新芯片拆卸BGA植球BGA焊接返修更换
1元
产品名:smt贴片,dip插件,qfn清洗,bga磨平

BGA植球BGA返修焊接QFN去锡磨平
1元
产品名:bga换料,qfp焊接,qfn磨平,cpu植球

蓝牙模块>蓝牙芯片拆卸除锡植球清洗编带加工
2元
产品名:bga 植球,qfn 除锡,qfp编带,sop编带

HILINX赛灵思芯片拆卸、除胶、除锡、清洗、植球
2元
产品名:BGA植球,CPU植球,QFN除锡,QFP除锡