SBD 在导通过程中没有额外载流子的注入和储存,因而反向恢复电流小,关断过程很快,开关损耗小。传统的硅肖特基二极管,由于所有金属与硅的功函数差都不很大,硅的肖特基势垒较低,硅 SBD 的反向漏电流偏大,阻断电压较低,只能用于一二百伏的低电压场合且不适合在 150 ℃以上工作。然而,碳化硅 SBD弥补了硅 SBD 的不足,许多金属,例如镍、金、钯、钛、钴等,都可以与碳化硅形成肖特基势垒高度 1 eV 以上的肖特基接触。据报道,Au/4H-SiC 接触的势垒高度可达到 1.73 eV,Ti/4H-SiC 接触的势垒比较低,但高也可以达到 1.1 eV。6H-SiC与各种金属接触之间的肖特基势垒高度变化比较宽,低只有 0.5 eV,高可达1.7 eV。于是,SBD 成为人们开发碳化硅电力电子器件关注的对象。它是高压快速与低功率损耗、耐高温相结合的理想器件。目前国际上相继研制成功水平较高的多种类的碳化硅器件。
SiC 肖特基势垒二极管在 1985 年问世,是 Yoshida 制作在 3C-SiC 上的,它的肖特基势垒高度用电容测量是 1.15 (±0.15) eV,用光响应测量是 1.11 (±0.03) eV,它的击穿电压只有8 V,只6H-SiC肖特基二极管的击穿电压大约有200 V,它是由 Glover. G. H 报道出来的。Bhatnagar 报道了个高压 400 V 6H-SiC 肖特基势垒二极管 ,这个二极管有低通态压降(1 V),没有反向恢复电流。随着碳化硅单晶、外延质量及碳化硅工艺水平不断地不断提高,越来越多性能的碳化硅肖特基二极管被报道。1993 年报道了只击穿电压超过 1000V的碳化硅肖特基二极管,该器件的肖特基接触金属是 Pd,它采用 N 型外延的掺杂浓度1×10cm,厚度是 10μm。的4H-SiC单晶的在 1995 年左右出现,它比6H-SiC的电子迁移率要高,临界击穿电场要大很多,这使得人们更倾向于研究4H-SiC的肖特基二极管。
金属与 N 型 4H-SiC 半导体体内含有大量的导电载流子。金属与 4H-SiC 半导体材料的接触仅有原子大小的数量级间距时,4H-SiC 半导体的费米能级大于金属的费米能级。此时 N 型 4H-SiC 半导体内部的电子浓度大于金属内部的电子浓度,两者接触后,导电载流子会从 N 型 4H-SiC 半导体迁移到金属内部,从而使 4H-SiC 带正电荷,而金属带负电荷。电子从 4H-SiC 向金属迁移,在金属与 4H-SiC 半导体的界面处形成空间电荷区和自建电场,并且耗尽区只落在 N 型 4H-SiC 半导体一侧,在此范围内的电阻较大,一般称作“阻挡层”。自建电场方向由 N 型 4H-SiC 内部指向金属,因为热电子发射引起的自建场增大,导致载流子的扩散运动与反向的漂移运动达到一个静态平衡,在金属与4H-SiC 交界面处形成一个表面势垒,称作肖特基势垒。4H-SiC 肖特基二极管就是依据这种原理制成的。
肖特基二极管的反向阻断特性较差,是受肖特基势垒变低的影响。为了获得高击穿电压,漂移区的掺杂浓度很低,因此势垒形成并不求助于减小 PN 结之间的间距。调整肖特基间距获得与 PiN 击穿电压接近的 JBS,但是 JBS 的高温漏电流大于 PiN,这是来源于肖特基区。JBS 反向偏置时,PN 结形成的耗尽区将会向沟道区扩散和交叠,从而在沟道区形成一个势垒,使耗尽层随着反向偏压的增加向衬底扩展。这个耗尽层将肖特基界面屏蔽于高场之外,避免了肖特基势垒降低效应,使反向漏电流密度大幅度减小。此时 JBS 类似于 PiN 管。反向漏电流的组成主要由两部分:一是来自肖特基势垒的注入;二是耗尽层产生电流和扩散电流。
碳化硅作为一种宽禁带半导体材料,比传统的硅基器件具有更的性能。碳化硅的宽禁带(3.26eV)、高临界场(3×106V/cm)和高导热系数(49W/mK)使功率半导体器件效率更高,运行速度更快,能够有效降低产品成本、体积及重量。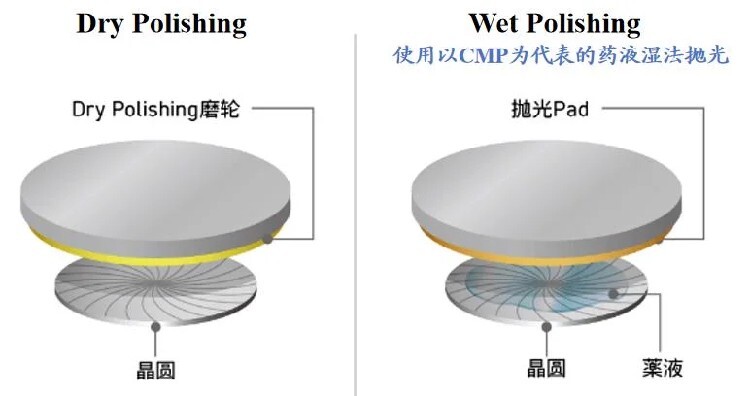
用碳化硅肖特基二极管替换快速PN 结的快速恢复二极管(FRD),能够明显减少恢复损耗,有利于开关电源的高频化,减小电感、变压器等被动元件的体积,使开关电源小型化,并降低产品噪音。

中山供应整流高压二极管多少钱一个
面议
产品名:整流高压二极管

深圳好用的氮化镓二极管厂家直销
面议
产品名:氮化镓二极管
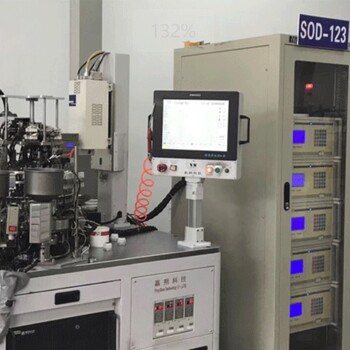
静安出售FRED快恢复二极管厂家直销
面议
产品名:FRED快恢复二极管

杨浦生产销售碳化硅肖特基二极管现货供应
面议
产品名:碳化硅肖特基二极管

长宁销售整流高压二极管厂家直销
面议
产品名:整流高压二极管

黄浦出售肖特基二极管报价
面议
产品名:肖特基二极管

黄浦出售瞬态抑制二极管价格
面议
产品名:瞬态抑制二极管

上海定制整流桥联系方式
面议
产品名:整流桥