DTS+TCB预烧结银焊盘工艺提高功率器件通流能力和功率循环能力
在新能源汽车、5G通讯、光伏储能等终端应用的发展下,SiC/GaN等第三代半导体材料水涨船高,成为时下火爆的发展领域之一。
可实现高可靠、高导电的连接的需求,很多Tier 1的控制器公司和Tier 2功率模组制造商,在汽车模组中均或多或少的采用该烧结银DTS技术,
目前烧结银技术主要用于对可靠性和散热高要求的市场,在引线框架制作上除了要提供高可靠度的镀银品质以符合烧结银的搭接技术以外,由于烧结银的膜厚只有20um-50um,不像传统的锡膏搭接方式可通过锡膏量的调整补正搭接面平整度不佳造成的搭接问题,烧结银的搭接技术对于搭接处的公共平面度要求公差只有20um,对于这种复杂的折弯成型式技术是一大挑战。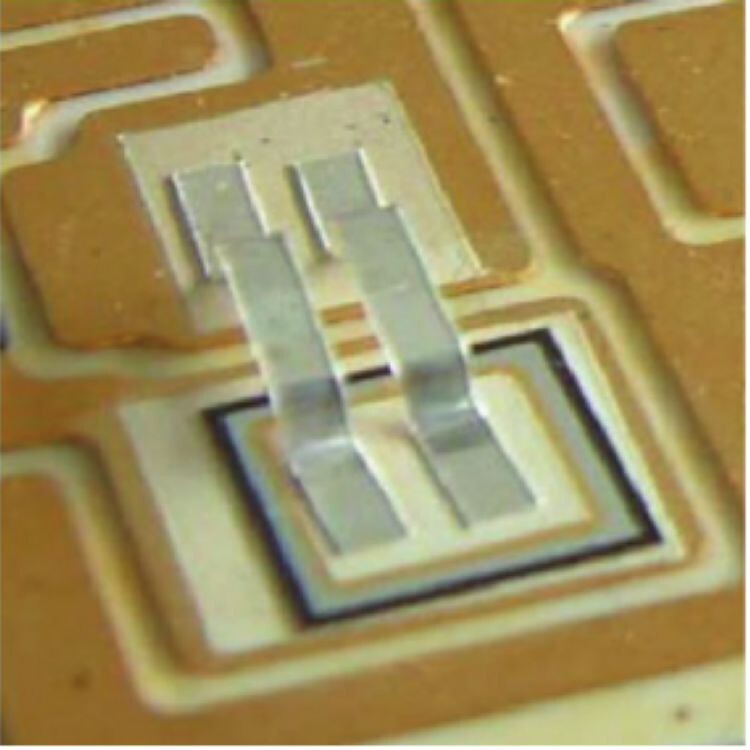
GVF预烧结银焊片(DTS+TCB(Die Top System +Thick Cu Bonding)不仅能显著提高芯片连接的导电性、导热性,以及芯片连接的可靠性,并对整个模块的性能进行优化,还能帮助客户提高生产率,降低芯片的破损率,加速新一代电力电子模块的上市时间。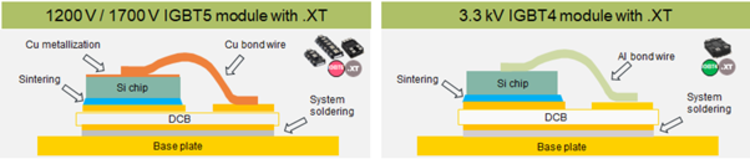
使用了GVF预烧结银焊片使器件结温可以超过200°C。因此,GVF预烧结银焊片可以大幅降低功率限额,或者在确保电流相同的情况下缩小芯片尺寸,从而降低电力成本。
GVF预烧结银焊片(DTS+TCB(Die Top System +Thick Cu Bonding)的使用方法为:Pick & Place;