烧结银可以解决现有存在的五个难题
总所周知,不论是碳化硅模块还是硅IGBT,电力电子发展总体目标是提高功率(电流,电压)——降低半导体控制和开关时损耗——扩展工作温度的范围——提高使用寿命,稳定性和可靠性——在降低失误率的同时简化控制和保护电路到后的降低成本。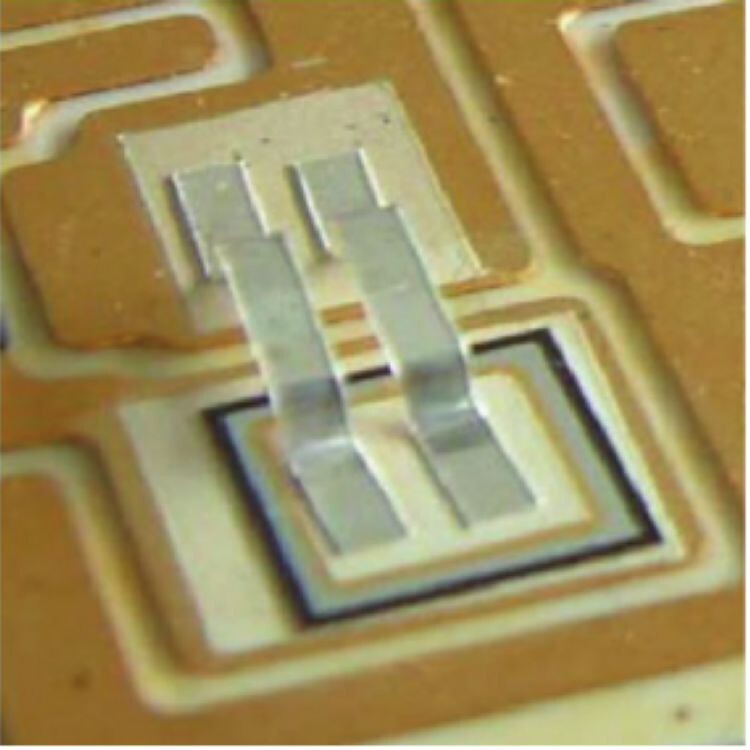
个难题:烧结银膏技术
在芯片与基板的连接中,传统有基板焊接功率模块中,焊接连接往往是模块上的机械薄弱点。
目前,银烧结技术成为国内外第三代半导体封装技术中应用为广泛的技术,美国、日本等碳化硅模块生产企业均采用此技术。
芯片连接采用银烧结合金而不是焊接,烧结连接熔点更高,这意味着在给定温度摆幅下连接的老化率将低得多,功率模块的热循环能力可增加5倍。
目前SHAREX开发的银烧结技术已经由微米银烧结进入纳米银烧结阶段,纳米加压烧结银与市面上原来售卖的微米烧结银技术相比:
善仁新材新推出的有压烧结银AS9385的剪切强度达到93.277MPa,剪切强度大大超过目前市面上主流的有压烧结银的剪切强度,大家可能对93.277MPa没有概念,作为对比,目前市面上的德国某品牌的有压烧结银剪切强度为68MPa,美国某品牌的有压烧结银剪切强度为67MPa。