在晶圆级的连接上善仁新材也有相关解决方案,如果贵公司既有晶圆的生产又有封装的制造,晶圆也直接把烧结银膜贴上去,后面做封装简单很多,效率也高很多,问题也少很多。
烧结银的应用:善仁新材针对电力电子功率模块的烧结银分为三部分。,加压烧结银AS9385系列。这个行业用的烧结银现在都是印刷膏状的,我们公司除了印刷膏状的,还有点涂膏类型的烧结银,应用点主要就是不平整的平面烧结需求,用印刷工艺用到3D印刷,这样就增加了印刷难度和工艺难度,但是如果点涂就可以很好解决问题。
善仁新材的TDS预烧结银焊片GVF9800,此类产品可以提高功率器件的通流能力和功率循环能力。还有一些应用在低压状态下的解决方案,比如像混合烧结、导电胶等,还有无压烧结银的解决方案都可以提供。
善仁新材的烧结产品在不同碳化硅模块等级里面的不同应用。我们把不同等级分为四大块,,芯片顶部的连接。第二,芯片的连接。第三芯片和基板的连接。第四,模块和散热器的连接。第五,晶圆级的连接。
SIC碳化硅芯片和基板的连接:我们所对应的解决方案,,烧结银膏,包括点涂、印刷、喷印的,还有各种等级的银膜。在芯片和基板烧结的工艺当中,就是银膜工艺,如果以前没有做过烧结银的模块封装,可能刚开始想试试烧结银的模块,推荐采用烧结银膜GVF9500的工艺,因为这个工艺简单,而且工艺窗口也宽泛,大家操控起来比较容易。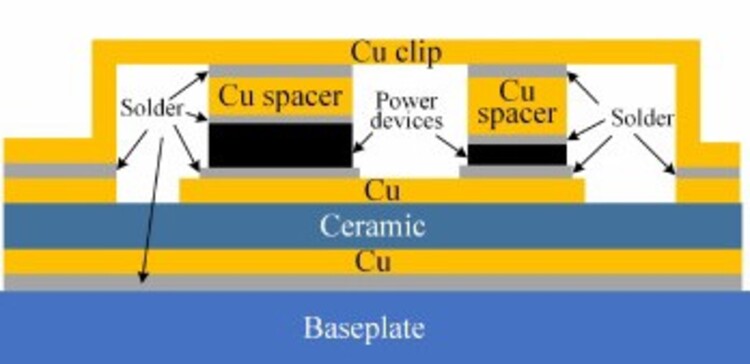
善仁新材的烧结银膏既有印刷的又有点涂的,也有干法工艺和湿法工艺。干法工艺先做一次烘干,做完烘干以后再把芯片贴上去再做压力烧结。这个工艺,对印刷的工艺要求很高,同时设备投资很贵。还有一种工艺就是湿法工艺,芯片印刷完或点涂完以后先做贴片,这样印刷或者点涂的不良可以很好地避免。