在成型技术也相当困难,由于电镀银是局部镀银,相较于全镀,部分镀银技术很难,做模具,且放置芯片处用局部银,一个导线架搭两个芯片,芯片局部银,其他引线框架用镍钯金,材料差异对引线框架制作是很大的技术挑战。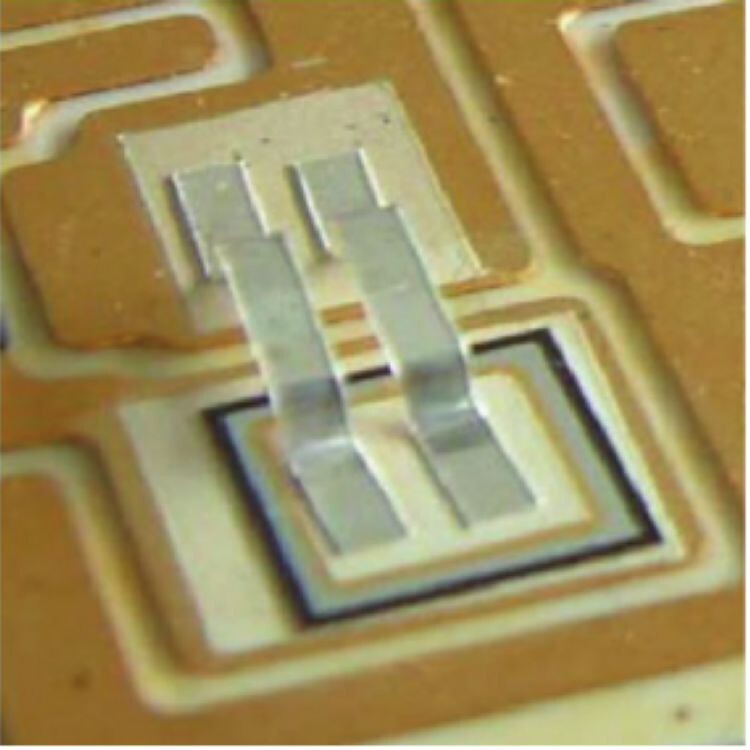
单管封装中引入扩散焊“Diffusion Soldering”,省了芯片与lead frame之间的焊料,优化了器件热阻。以1200V/30mOhm的SiC MOSFET单管为例,基于GVF预烧结银焊片,相比当前焊接版的TO247-3/4L,可降低约25%的稳态热阻Rth(j-c),和约45%的瞬态热阻。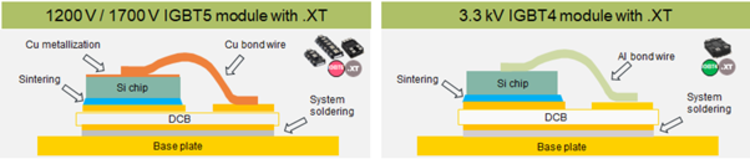
使用了GVF预烧结银焊片使器件结温可以超过200°C。因此,GVF预烧结银焊片可以大幅降低功率限额,或者在确保电流相同的情况下缩小芯片尺寸,从而降低电力成本。